近日,南京屹立芯创半导体科技有限公司(以下简称“屹立芯创”)自主研发的真空压力除泡系统正式启运出海,交付对象为OSAT头部企业,这是屹立芯创在国际化道路上的又一重要突破,也是中国高端半导体装备在海外高端市场斩获的关键里程碑。

微米级气泡:先进封装的隐形杀手
在先进封装向高密度、超薄化与异质集成迈进的道路上,微米级气泡已成为不容忽视的共性技术瓶颈。
于3D堆叠、超薄芯片(<50μm)及2.5D/3D封装等前沿结构中,任何微小气泡都可能成为封装失效的“隐形导火索”。
这些气泡虽微,危害却深远:
l 削弱界面结合强度,侵蚀有效粘接面积;
l 阻塞芯片散热路径,形成局部高温热点;
l 在回流焊或温度循环中膨胀,产生内部应力,诱发芯片裂纹或界面剥离。
随着芯片与DAF膜厚度持续减薄,气体逸出通道被严重压缩,除泡难度呈指数级上升。在多层堆叠架构中,即便是深藏于底层的一颗微米气泡,也可能触发整个封装结构的“多米诺”式力学失稳。

破局之道:真空压力技术精妙协同
面对微米级气泡的行业难题,屹立芯创以真空、热流与压力的多场协同,实现对气泡的精准清除。
其技术核心在于多重多段真空压力智能切换系统。该系统通过专利的多段式真空-压力循环程序,对贴装后界面气泡实现动态深度清理:
l 高真空抽吸:强力提取并扩大溶解与游离的微米气泡,使其脱离界面束缚;
l 静高压渗透:施加均匀高压,促进胶体二次流动,挤压并溶解残留气泡;
l 多轮循环清除:通过多次循环,彻底清除边缘气阱等复杂气泡,达成完美界面填充。
该系统的核心优势在于其灵活可调的多段真空-压力切换能力,可根据不同封装材料的特性精准设定工艺参数,广泛适配于各类复杂封装场景。
技术创新:智能系统打造差异化优势
屹立芯创真空压力除泡系统融合了多项创新专利技术,形成了明显的差异化优势。
该系统整合八大智能系统,包括:智能真空/压力切换、智能控氧、智能安全保护、智能挥发物收集、智能压力控制、智能温控、智能诊断及自动化整合系统。
基于“多参数耦合控制”理念,系统实现了工艺环境的高精度与全流程可追溯,在显著提升产品良率与封装可靠性的同时,有效降低能耗与人工成本。
区别于传统的单点功能堆砌方案,屹立芯创率先实现“真空度-压力值-温度曲线”三参数动态联动调控,突破了行业技术瓶颈,为复杂封装场景提供更智能、可靠的解决方案。
应用全景:覆盖先进封装核心场景
贴膜除泡:攻克贴合界面气泡难题,为芯片堆叠/micro LED/OCA提供无缺陷贴合保障;
底填除泡:守护微米互连可靠性,确保倒装芯片封装长期稳定运行;
灌封除泡:实现模块级结构保护,提升车规与功率器件在恶劣环境下的耐久性;
铟TIM除泡:突破散热界面导热瓶颈,为CPU/GPU/AI芯片释放极致性能潜能。
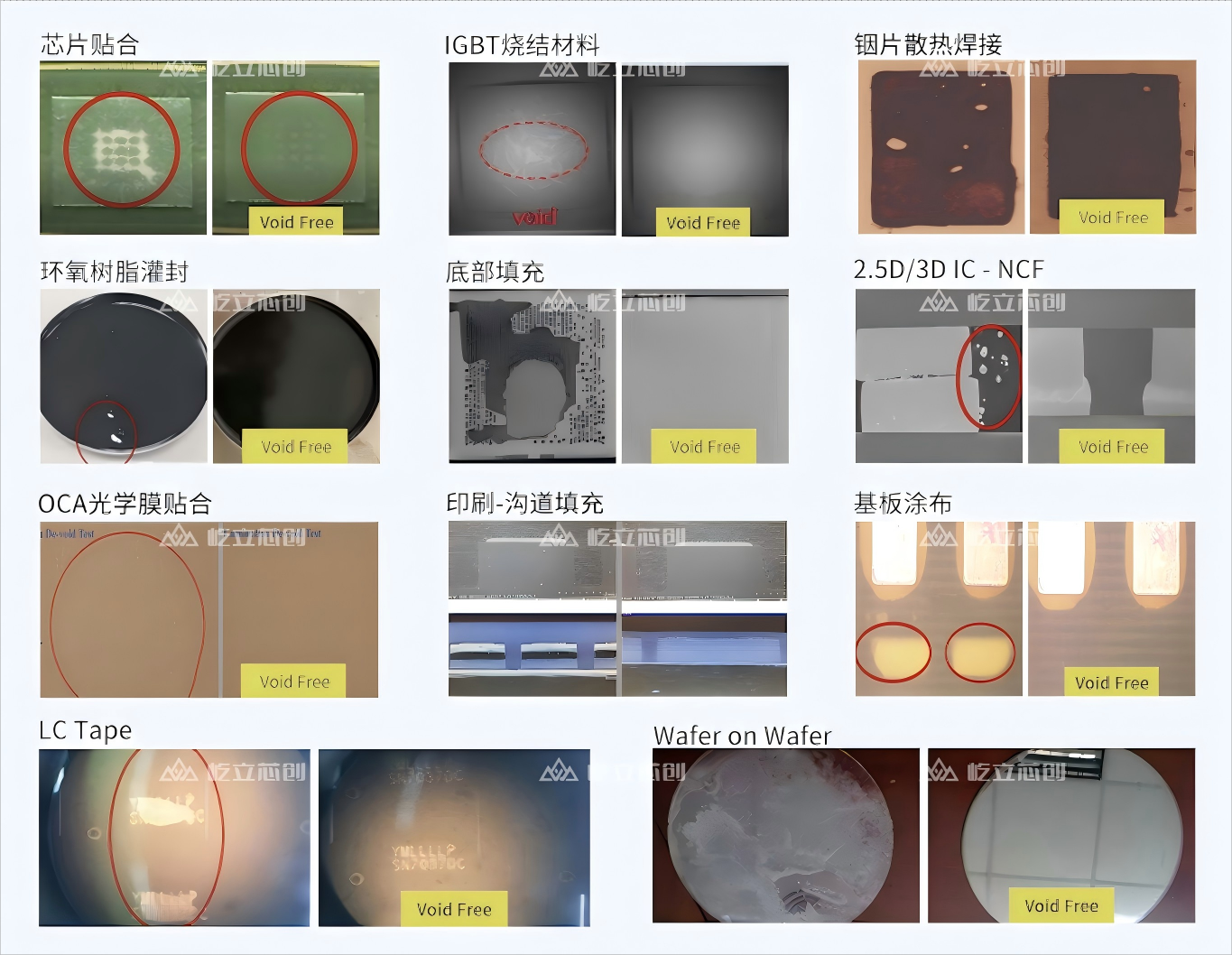
在全球电子制造业格局重塑与先进封装需求爆发的时代浪潮下,屹立芯创的每一次交付,不仅标志着企业自身的技术跨越,更彰显中国高端半导体装备从“跟跑”到“并跑”的国际进阶。
展望未来,屹立芯创将坚守“科技创新驱动、良率提升为本、产业链共赢”的理念,持续深耕研发、精进产品、拓展合作,立志成为全球半导体热流与气压技术领域的引领者。